Формирование и исследование мемристорных элементов на основе оксидов меди и титана с использованием магнетронной технологии
Формирование и исследование мемристорных элементов на основе оксидов меди и титана с использованием магнетронной технологии
Аннотация
Представлены результаты получения резистивных элементов памяти на стеклянных подложках. Образцы представляли собой структуры металл/диэлектрик/металл, активный слой которого был получен магнетронным распылением составной титаново-медной мишени. Электронно-микроскопический анализ показал, что активный слой после процесса переключения имеет вертикально ориентированную морфологию, что может дополнительно подтверждать филаментарный механизм перключения. Изучены вольт-амперные характеристики и эффект резистивного переключения. Обнаружено, что предложенных способ получения диэлектрического слоя является подходящим для изготовления мемристоров. В частности, продемонстрировано, что применение данных пленок в структуре мемристивного элемента памяти позволяет получить отношение состояния с высоким электрическим сопротивлением к состоянию с низким электрическим сопротивлением более чем 102.
1. Введение
Объем хранящихся в мире цифровых данных за последние десять лет кратно увеличился. Этим обстоятельствам вызван большой интерес к устройствам, демонстрирующим эффекты обратимого резистивного переключения, открывающим путь к созданию сверхъёмких модулей памяти, благодаря наложению нескольких слоев друг на друга, что позволит получить переключающий многомерный и многоканальный механизм, работающий с несколькими слоями одновременно и независимо. Мемристорная память может обладать высокими эксплуатационными характеристиками такими, как быстродействие, энергонезависимость, значительное количество циклов переключения и возможностью сохранять информацию длительное время в широком диапазоне температур , , , , . Вместе с тем поиск материалов диэлектрического слоя мемристора и выбора электродов являются предметом интенсивных исследований
Толкование эффекта резестивного переключения в мемристивных структурах сводится к процессам миграции вакансий кислорода в диэлектрических слоях или ионов металлов, имплантированных в этот слой
, , . Внешнее электрическое поле инициирует образование или разрушение токопроводящих каналов, что и влияет на изменение электрического сопротивления мемристора. Большинство мемристивных устройств на сегодняшний день изготавливаются с использованием различных неорганических , , , и органических материалов , , но одним из первых, и по-прежнему самым популярным, является диоксид титана.В настоящей работе развивается подход к использованию в мемристорных структурах оксидов Ti и Cu, разработанным технологическим режимом осаждения диэлектрика путем магнетронного распыления составной титаново-медной мишени в кислородосодержащей среде.
2. Методика получения и результаты
Конструкция, исследуемых мемристорных структур, представляет собой структуры металл-диэлектрик-металл. В качестве нижнего и верхнего электродов применялся слой алюминия толщиной 70 нм, полученный методом термического испарения. Алюминий был выбран по причине простоты осаждения, к тому же целью данной работы являлось исследование именно диэлектрического слоя. В основе методики формирования активного слоя, рассматриваемых в настоящей работе мемристорных структур, заложены процессы, протекающие в плазме тлеющего разряда, создаваемого магнетронным источником распыления, катодом которого являлась составная мишень Ti:Cu (титан-медь). Схема магнетронной установки проиллюстрирована на рисунке 1. При этом относительная площадь, занимаемая медными дисками на составной мишени, была около ∼15 % от общей площади зоны распыления мишени. Распыление проводилось в атмосфере воздуха при парциальном давлении 6×10-3 мм рт.ст. и токе разряда 150 мА.
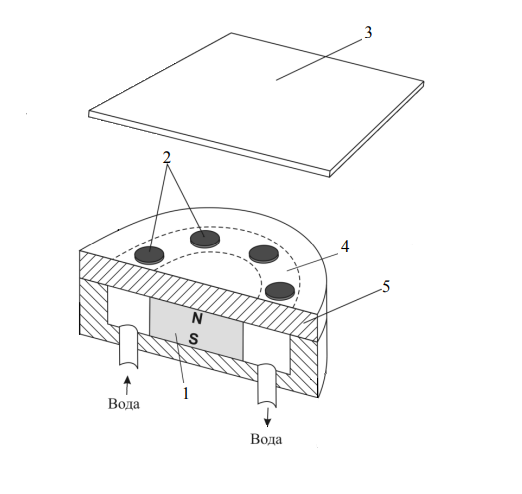
Рисунок 1 - Схематическое изображение магнетронной распылительной системы:
1 – постоянный магнит; 2 – медные диски; 3 – подложка; 4 – зона распыления; 5 – составная мишень (Ti:Cu)

Рисунок 2 - Энергодисперсионный рентгеновский спектр диэлектрического слоя, осажденного магнетронным распылением составной мишени на кремниевой подложке
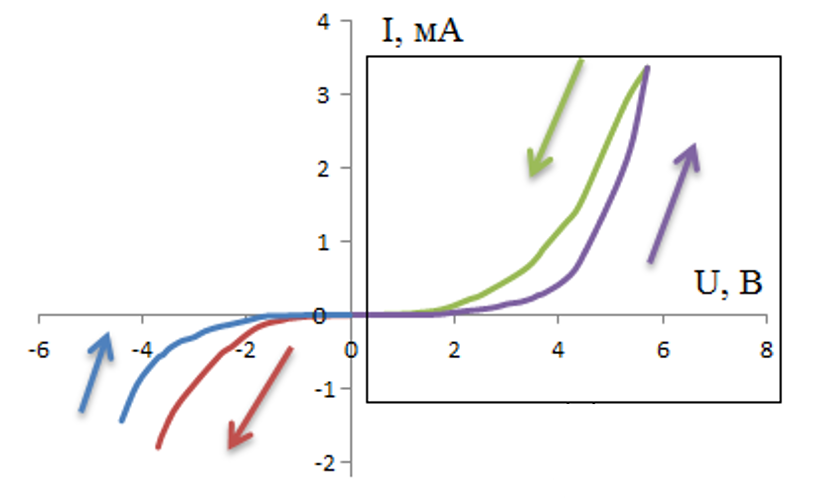
Рисунок 3 - Вольт-амперная характеристика структуры на основе оксида титана:
фиолетовый - при увеличении напряжения; зелёный - в обратном направлении; красный - при увеличении напряжения в отрицательной области; синий - в обратном
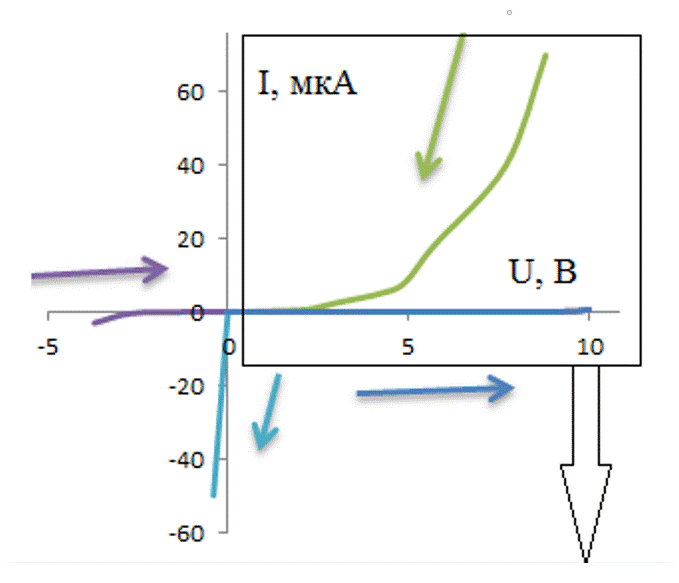
Рисунок 4 - Вольт-амперная характеристика структуры на основе пленок оксида меди с примесями оксида титана, полученного методом магнетронного распыления составной мишени:
синий - при увеличении напряжения; зелёный - в обратном направлении; голубой - при увеличении напряжения в отрицательной области; фиолетовый - в обратном

Рисунок 5 - Зависимость в логарифмическом масштабе для структуры на основе оксида титана:
синяя кривая - при увеличении напряжения; красная - в обратном направлении
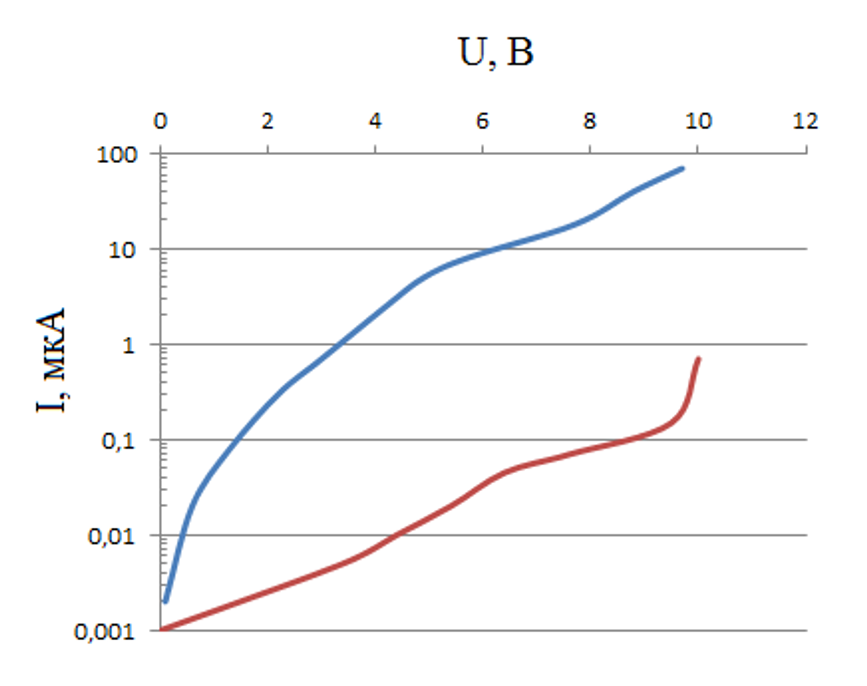
Рисунок 6 - Зависимость в логарифмическом масштабе для структуры на основе пленок оксида меди с примесями оксида титана, полученного методом магнетронного распыления составной мишени:
красная кривая - при увеличении напряжения; синяя - в обратном направлении
Важным стоит упомянуть, что скорость формирования диэлектрического слоя методом магнетронного распыления составной мишени при токе разряда 150 мА составляла 16 нм/мин, что превышает скорость осаждения пленок диоксида титана при том же режиме напыления примерно в 4-5 раз. Этим обстоятельством вызвано преобладание оксида меди в активном слое так как скорость распыления меди кратно больше скорости распыления титана. Толщина диэлектрического слоя при котором проявляется мемристивный эффект таких структур лежит в диапазоне от ∼60 нм до ∼400 нм. На рисунке 4 показана типичная вольт-амперная характеристика мемристора с толщиной диэлектрического слоя ~ 200 нм. Стоит обозначить, что общий вид вольт-амперных характеристик не меняется от изменения толщины активного слоя, а меняется только величина напряжения переключения. По этой причине имеет место сравнительный анализ со структурами без модификаций медью. К тому же характерным для данных пленок является скачкообразный переход в низкоомное состояние.
При исследовании запоминающих свойств данных пленок важно выяснить механизм переключения, реализуемый в представленных структурах. С этой целью было снято растровое изображение торцевого скола структуры с применением TESCAN MIRA 3LMU до и после переключения в низкоомное состояние. Результат представлен на рисунке 7. Можно наблюдать вертикально-ориентируемую морфологию, которая может подтверждать, филаментарный механизм переключения. Стоит упомянуть, что основной причиной нестабильности характеристик мемристорных устройств является неоднородность распределения электрического поля в активном слое мемристора, в связи с отсутствием строгой геометрии в диэлектрическом слое резистивного элемента памяти.
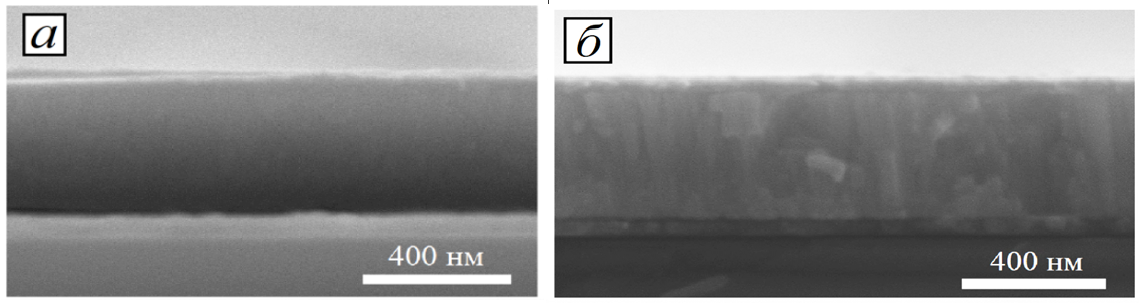
Рисунок 7 - РЭМ-изображение торцевого скола мемристивных структур без воздействия электрическим полем (а), после переключения в низкоомное состояние (б).
3. Заключение
Рассмотрена методика получения пленок оксида меди с примесями оксида титана, полученных магнетронным распылением составной мишени, для создания на их основе мемристорных структур. С применением растровой электронной микроскопии были получены снимки торцевого скола тонкопленочной структуры. Результатом этого исследования является подтверждение, доминирующего в настоящий момент филаментарного механизма, реализуемого в представленных в настоящей работе мемристорных структурах. Также продемонстрировано кратное увеличение отношения высокоомного состояния мемристора к низкоомному по сравнению с мемристорами, которые были изготовлены без медных дисков на титановой подложке в процессе магнетронного осаждения.
Полученные результаты показывают целесообразность использования представленной технологии осаждения диэлектрических материалов для изготовления резистивных элементов памяти.
Механизм влияния атомов меди на свойства мемристорных структур требует проведение отдельных исследований.
